Application
PE-MOCVD

TaO Film
処 理 : TaO ( タンタルオキサイド)
用 途 : キャパシター膜・耐薬液性(酸・アルカリ)
処理方法 : LLD ( Layer-by-Layer Deposition )
成膜温度 : 150-400℃

AlO Film
処 理 : AlO ( アルミニウムオキサイド)
用 途 : ゲート膜 ・水素ブロック膜 ・キャパシター膜
処理方法 : LLD ( Layer-by-Layer Deposition )
成膜温度 : 300-400℃
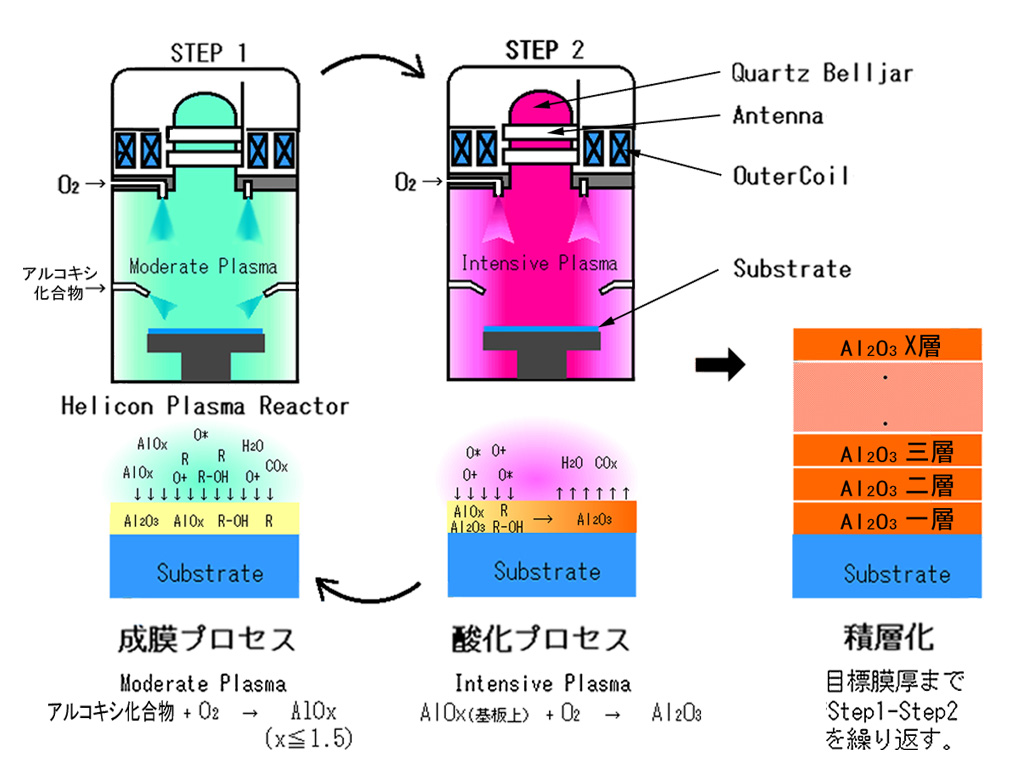
LLD(Layer – by – Layer Deposition)
成膜と酸化を繰り返し実施する成膜方法で1 回あたりの成膜厚さと成膜回数を適宜選 択し所望の膜質・膜厚を得る
PE-CVD

Sio Film
処 理 : SiO (シリコンオキサイド)
用 途 : 絶縁層膜 ・ ゲート膜
処理方法 : PE-CVD

SiN Film
処 理 : SiN (シリコンナイトライド)
用 途 : 水ブロック膜 ・ キャパシター膜 ・ ストレスライナー
処理方法 : PE-CVD
Plasmatreatment

Oxidation
処 理 : 酸化処理
用 途 : 各種金属酸化膜の再酸化 ・ 有機物除去
処理方法 : 高密度プラズマ処理

Nitridation
処 理 : 窒化処理
用 途 : ゲート酸化膜の窒化 ・ 金属窒化膜の表面窒化処理
処理方法 : 高密度プラズマ処理
Ashing

Ashing
処 理 : レジストの除去
用 途 : マスクレジスト除去 ・ l/l 後硬化レジストの除去
処理方法 : 高密度プラズマ処理